硅氮化物蚀刻是半导体制造的一部分的基础。通过工艺温度和H的组合来决定整体硅(Si)蚀刻速率2而选择性是由Si能级定义的。
可以通过折射率,电导率或非接触来监测水含量近红外光谱-后者是最可取的方法。已经设计了一系列商用分析仪用于此目的。
硅的测量是这一过程的主要挑战,并提出了一种自动分析传统硅中的硅的方法3.N4蚀刻液已在前面概述过。然而,高选择性过程需要使用新的解决方案。
为了实时测量氮化硅腐蚀工艺槽,已经开发了多种方法。这些分析的结果可以用于严格的过程控制,以实现高选择性的氮化硅去除。
H3.宝4和H.2O测量
两个小时3.宝4和H.2O可以用近红外光谱法和电导率法测量。两种方法的性能总结见表1。
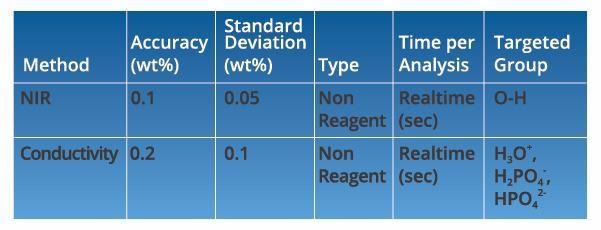
来源:ECI技术
比较h3.宝4在线自动化NIR方法和离线ICP-MS之间的结果显示,在线结果与ICP-MS结果相当,但具有较高的时间响应(<5分钟)以及自动采样和反馈的增加的好处.应注意,通过ICP-MS的实验室分析可能需要几周的Fab物流。
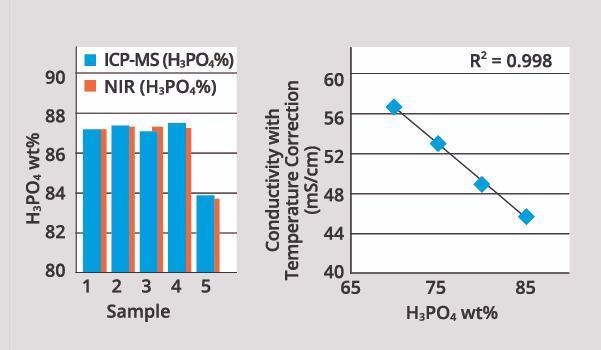
图像信用:ECI技术
导电率
电导率代表在电场驱动力下的离子迁移率。电导率对温度高度敏感,要求使用现代温度控制装置来实现高效的温度控制,极大地抑制了温度变化的影响。
上图显示了特征导电校准曲线,包括温度校正。这证实了与H的良好相关性3.宝4浓度。
SI测量
通过将预定浓度的氟离子添加到预定量的蚀刻剂溶液中来执行硅的测量。a的潜力氟离子专用电极(FISE)在这个测试溶液中测量。
在理想情况下,由已建立的NERNST等式给出了FILE的潜在(e):
E = E0- (2.303 RT/F) log [F- - - - - -]
低温腐蚀中硅的测量
使用湿式台式低温热磷蚀刻工艺进行SI测量。

图像信用:ECI技术
有机硅酸盐测量
向试剂中加入羧酸可提高灵敏度。灵敏度也可以通过在试剂中加入不同馏分的醋酸来研究。

图像信用:ECI技术
该方法可以使用离线ICP-MS法评估试剂中羧酸的方法。已发现这种改进的闪闪发料方法的结果与ICP-MS的匹配。
与试剂中羧酸相同的方法结果也显示出良好的有机硅酸盐的稳定性,所有测量结果都验证了具有<2%的准确度。

图像信用:ECI技术
结论
已经开发了一系列方法来实现精确测量氮化硅腐蚀工艺槽实时。从这些分析返回的结果可以用于严格的过程控制中,以实现对氮化硅去除的高选择性。
参考
- S.J.Baffat,M.S.Lucey,M.R. Yalamanchilli“热磷酸APC为硅氮化物蚀刻”,半导体国际,8/1/2002
- Hong等人,“用于蚀刻的组合物及其形成半导体器件的方法”,美国专利9,136,120
- Cho等人“用其制作半导体器件的蚀刻组成和方法”,美国专利8,821,752
- Nowling等人,“利用磷酸溶液低温蚀刻氮化硅结构”,美国专利8,716,146
- Shalyt等人。“磷酸蚀刻剂溶液中硅浓度分析”,美国专利8,008,087
- E. Shalyt,G. Liang,P.Bratin,C. Lin“控制清洁和蚀刻解决方案的实时监测”,SPWCC会议的收益,2007年
- Shalyt等,“磷酸蚀刻液中硅浓度的分析”,美国专利申请20160018358

此信息已采购,从ECI技术提供的材料进行审核和调整。欧洲杯足球竞彩
欲了解更多信息,请访问ECI技术。