目前正在生产的半导体器件的一个重要部分被归类为发光二极管(led)。
led的光的选择时,大多数照明应用程序中,对传统使用房间的灯也为新显示技术,包括高清电视、智能手机和增强现实耳机。
~ 10%更高的效率和~ 3 x比紧凑型荧光灯泡寿命更长,这人气不足为奇;此外,设备快,小,直接可寻址。
的过程制造μLEDs和类似的半导体器件可以多级(通常是几百个不同的步骤)和过程可以持续数周。

图1所示。显示设备采用μLEDs,包括(左)领导的电视,头戴显示设备(中)增强现实,(右)智能手机。图片来源:Gatan Inc .)
因此,必须分析和确定设备可行性在制造的过程中为了避免任何进一步的处理有缺陷或故障设备,以及进行失效分析(FA)通过优化来改善未来的吞吐量批次处理步骤。
图2描述了一个简化的工作流程wafer-mountedμLEDs。

图2。流程图说明设备生产μLEDs。图片来源:Gatan Inc .)
今天,仍然是一个缺乏无损缺陷识别的技术,可用于生产步骤之间识别的缺点,如电气短裤,处理缺陷,介质层断层或半导体组成计量,尽管迫切需要增加μLED设备产量。
然而,公告Monarc®的阴极发光(CL)检测器扫描电子显微镜(sem)将改变这种状况。
新Monarc探测器提供发光特性从6“纳米晶圆级别,并提供最精确的相关性与其他信号。
这种能力促进了地形的同时捕获,成分和晶体信息,大大提高故障分析能力。
方法
发出的光从一个示例兴奋高能电子(或称为CL)展示了实际价值的化合物半导体行业设备特性和过程开发和分析介电材料是一种有价值的工具。欧洲杯足球竞彩
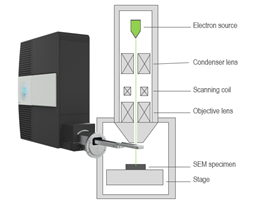
图3。Monarc CL探测器与扫描电子显微镜。图片来源:Gatan Inc .)
材料标识,这是不容易由传统的光学或电子显微镜分析,通过光谱分析。1执行CL在电子显微镜的一个显著优点是纳米级分析现货可以协助整片检验(计量)描述个人microLEDs的纳米级。

图4。CL光谱从掺稀土陶瓷,揭示排放在紫外,可见光和近红外部分的电磁波谱。图片来源:Gatan Inc .)
时确定元素组成与微观空间分辨率、能量色散谱(EDS) SEM是一个关键的和关键技术。使用EDS技术在失效分析(FA)是理想的技术提供了分析样品发出x射线的能量分布。
从这些信息,可以确定元素的分布。
结果与讨论
这项工作监督的分析商业GaN-In制造x遗传算法1 - x基于N多个量子井发光)miniLEDs捏造4英寸蓝宝石衬底上使用Gatan Monarc CL和EDAX辛烷精英EDS系统,这两个被连接到一个FE-SEM。
描绘在图5中,每一个矩形(图5)是由一堆材料生长和选择性地蚀刻在序列。欧洲杯足球竞彩其中包括-从下到上一层薄薄的AlN缓冲层,~ 2μm n-GaN, ~ 2μm Si-doped N +甘,200海里的发光层,300海里的化学计量P-GaN, 100纳米的氧化铟锡(ITO),涂上了~ 300纳米的SiO2和金属接触。
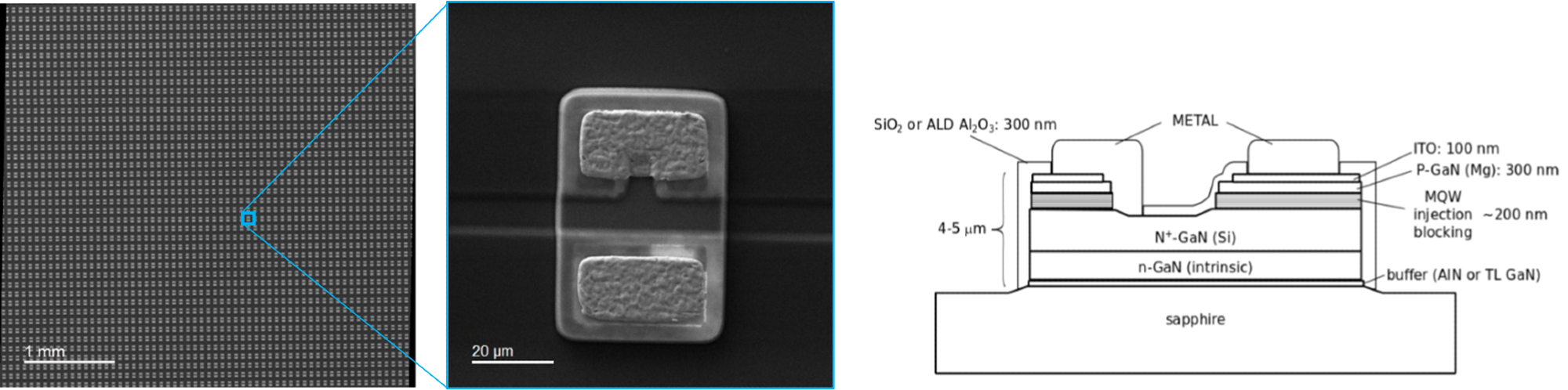
图5。(左)低的放大视图部分完成LED晶片。(中)领导的一个二次电子图像。(右)的横截面示意图InGaN /氮化镓发光了。图片来源:Gatan Inc .)
而优秀的显示表面形态,SEM图像明显缺乏信息的存在和一致性导致材料分布和缺陷。
导致设备的分析是由CL成像,显示几个缺陷用于FA评估处理诱导损伤,材料组成和制造缺陷。
Handling-Induced缺陷
作为显示在图6中,二次电子捕获和过滤CL图像大面积(~ 16毫米2)。~ 1%的CL图像显示低亮度led表现出低亮度——一个缺陷,没有确定相应的扫描电镜图像。
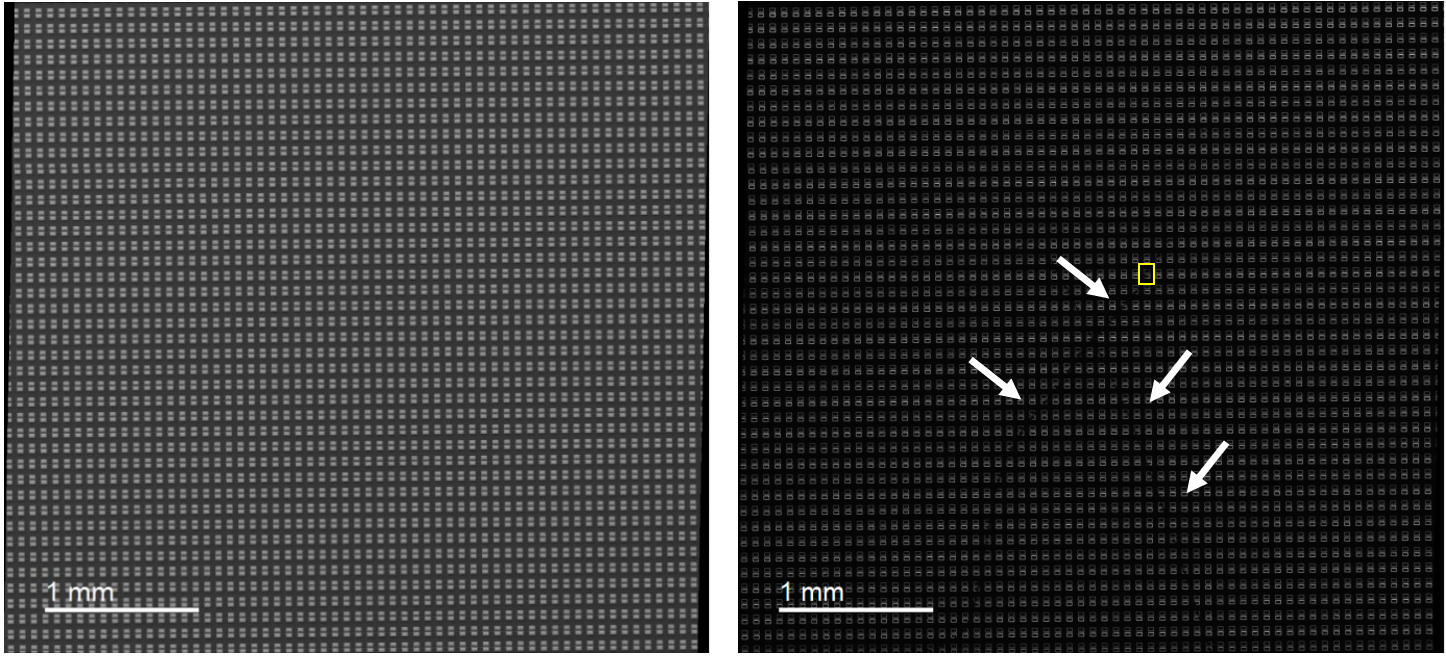
图6。(左)的二次电子和(右)CL图像mini-LED数组。CL图像揭示了一系列叛逃led形状的一个“x”降低强度。图片来源:Gatan Inc .)
受影响的设备出现在一个“X”的模式,尤其是没有对应设备列和行模式。确定这个缺陷可能是由于处理不当引起的在制造的过程中。
确定缺陷的来源和设备是否仍然可行的实施,这些有缺陷的设备进一步调查。
如图7所示,CL光谱图像(高光谱地图)拍摄的缺陷发光二极管(黄色框)。CL地图显示表面的影响主要是影响发射发光层,机械刮伤,这可能是介绍发光后但在金属沉积。
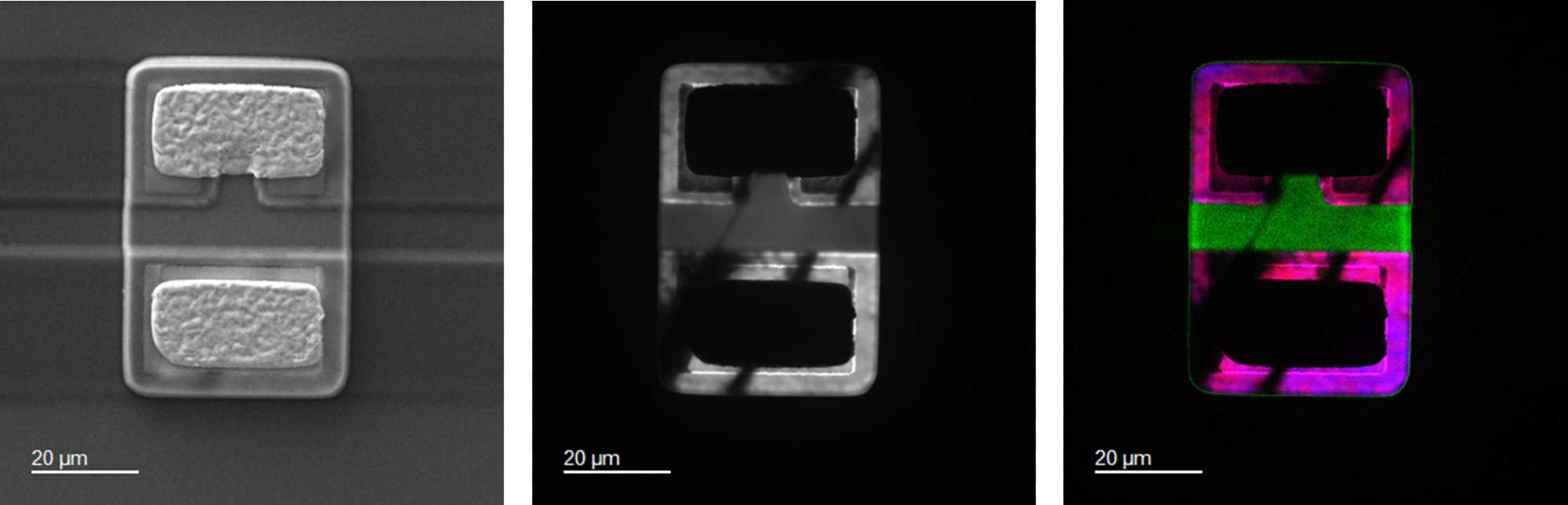
图7。(左)二次电子图像,(中心)CL光谱图像显示波长300 - 700纳米,和(右)彩色的光谱图像突出排放氮化镓(360 nm、绿彩色化),和InxGa1-xN (430 nm,蓝色的彩色化;和460海里,红色的彩色化)20 nm带宽。每种颜色的乐队是由强度归一化。图片来源:Gatan Inc .)
这些缺陷很可能损害了电气通路,因此,LED发光将显著降低或规避。结果,是决定他们应该拒绝进一步的处理。
通过使用CL,可以确定哪些设备被破坏,生成和地图可能允许用户有选择地叛逃设备排除在进一步处理。
这些缺陷会导致晶片区域的大型区域的排斥,支持几十种设备。这样的缺陷通常是最容易避免,因为它们源自人类交互——例如,在交流工具在处理或晶圆传输。
电气缺陷
不幸的是,包装设备性能下降只是整个数组的问题会导致缺陷影响led的电气连接。最常见的电气缺陷包括开路和短路。
如图8所示的画所描绘的,一个失踪的led灯观察金属接触垫,一个缺陷导致的设备可能表现得像一个开路电。由于金属层的CL图像明亮的地区应该是,失踪的接触垫很容易找到。
CL亮度为2.5 x比包层的地区由于没有包覆层。
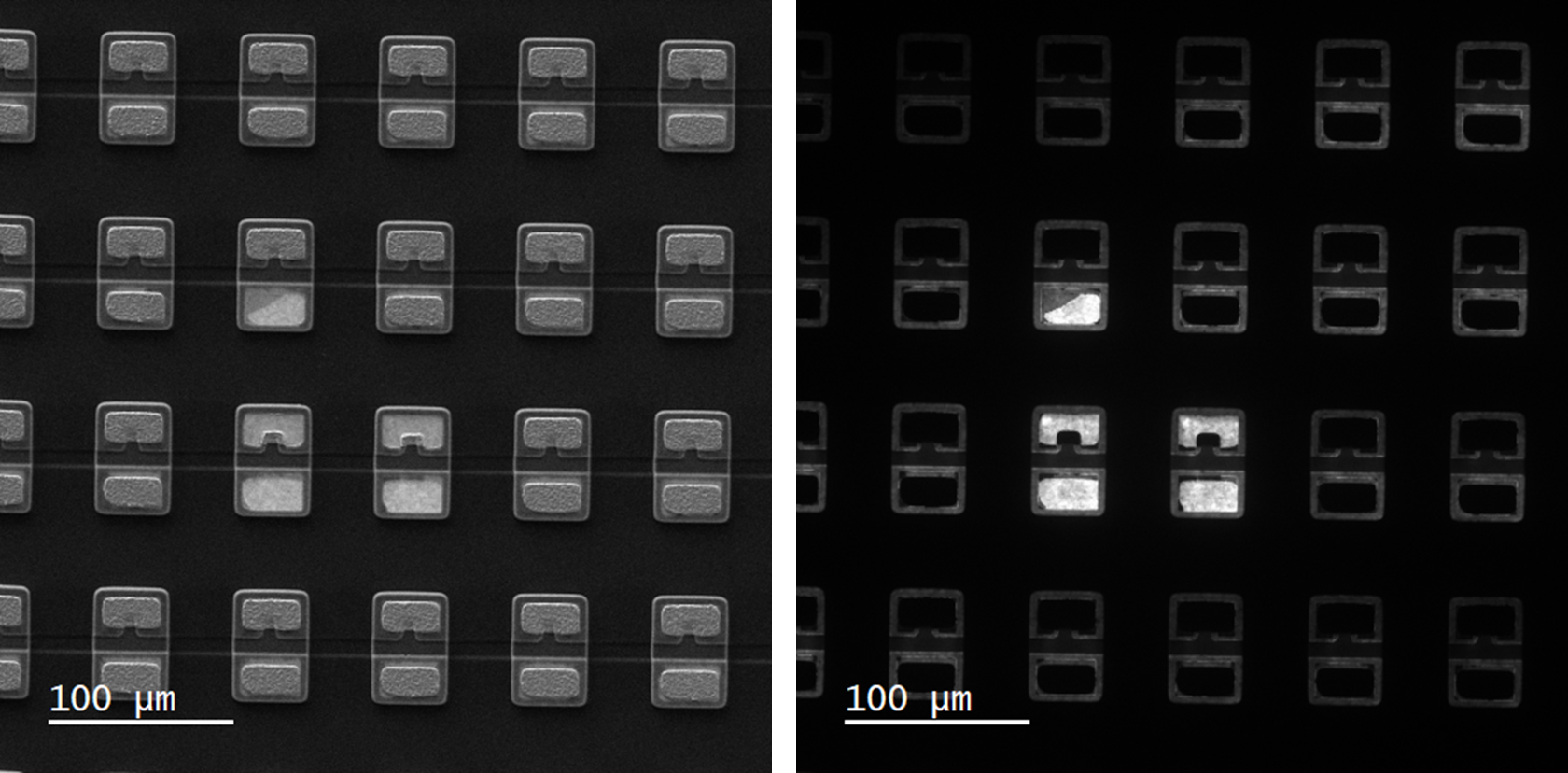
图8。(左)二次电子的led和(右)未经过滤的CL图像丢失的金属接触垫。图片来源:Gatan Inc .)
图9显示了LED电短的缺陷。这样的缺陷是致命的,因为他们阻止了功能和另外会导致功率损耗。
接触材料和演示了一个投下阴影bright-to-dark对比度高达7:1与周围地区。二次电子图像的对比度仅仅是2:1。
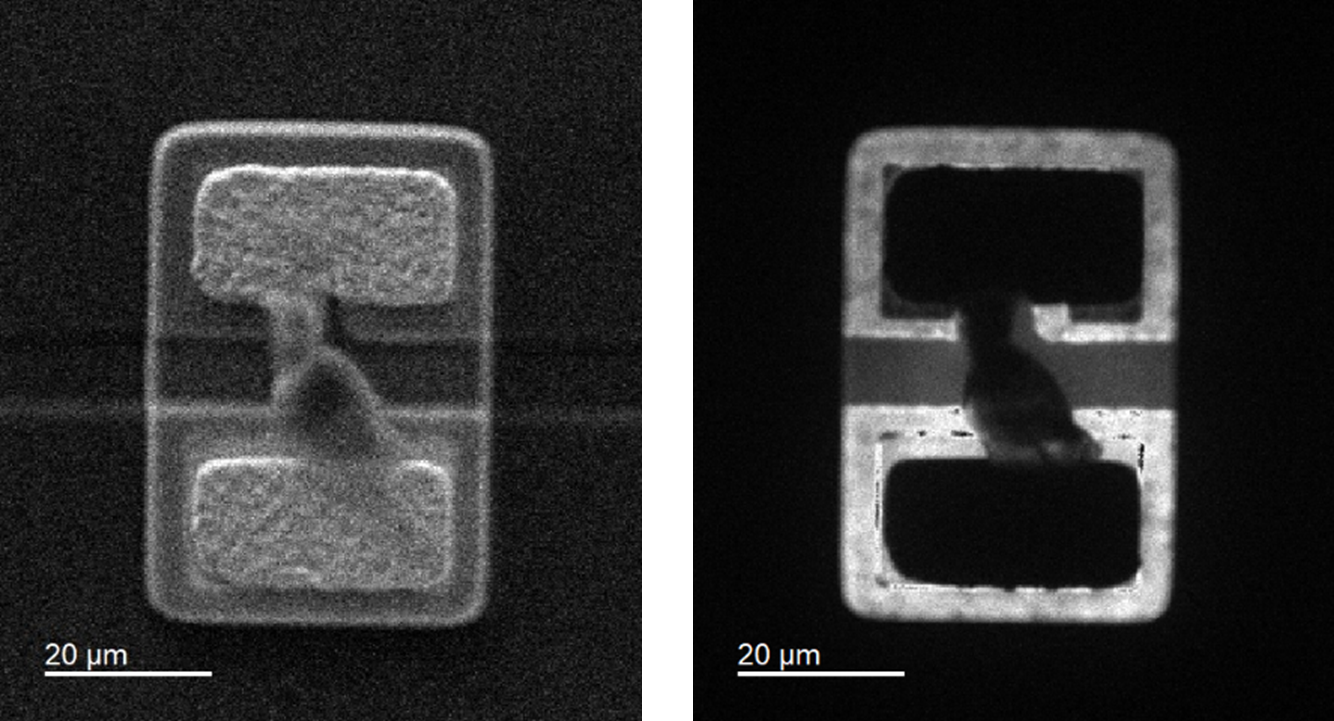
图9。(左)二次电子图像和相应(右)CL图像的电子短叛逃了。图片来源:Gatan Inc .)
观察CL图像大大简化了电的发现短的缺陷。CL地图提供了一个增强的对比,便于更健壮的设计算法自动故障检测算法,在设备产量随之增加。
制造缺陷
其他几个缺陷也揭示了CL映射。这些缺陷包括制造缺陷靠近上部和下部装置接触,所描绘的图10。CL,在这种情况下,并没有提供一个清晰和明确的解释的本质缺陷。
EDS映射和CL成像进行了同时确定缺陷的类型。
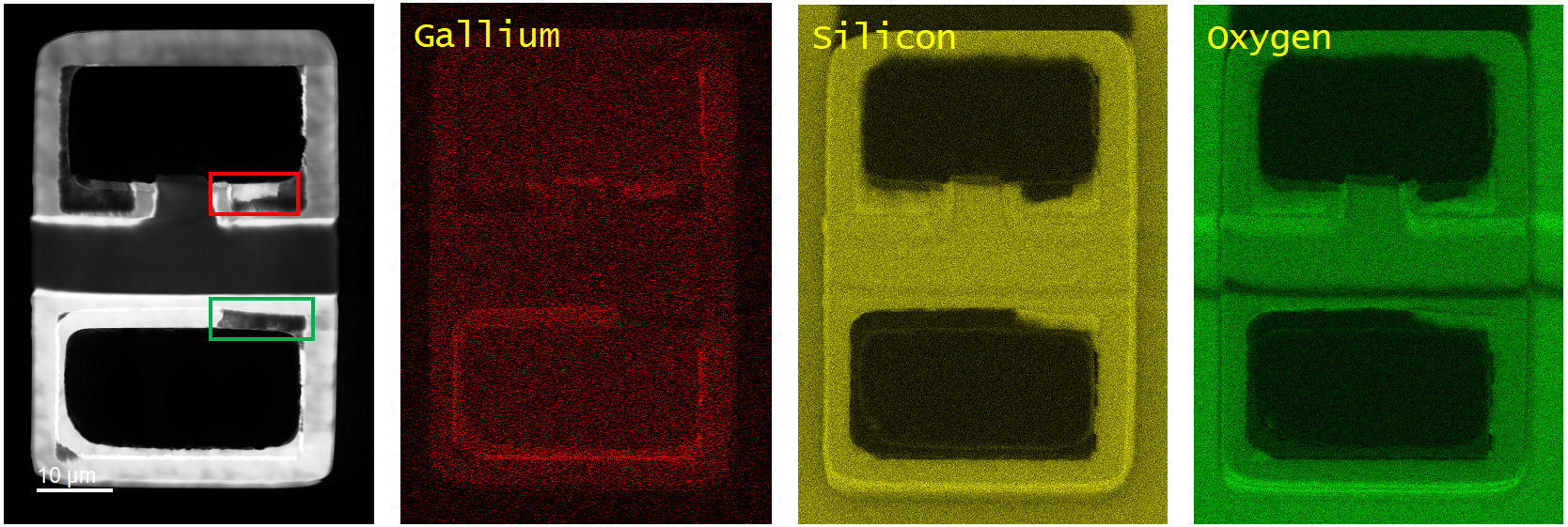
图10。(左)过滤CL图像和EDS材料组成一个缺陷导致的结果。EDS材料映射镓(红色)、硅(黄色)和氧(绿色)。图片来源:Gatan Inc .)
如图10所示,EDS地图暴露当地硅和氧不足和过剩镓的缺陷SiO所带来的红框所示2升空时被无意中删除一个加工阶段;其他地区(绿框)透露过多的SiO2。
材料组成
在图11中(左),然而,CL图像显示很强的排放强度和显示一些领导表面变化(不被不透明的金属覆盖层)。
在图11显示了一个图像中心光谱图像捕获和彩色的揭示indium-fraction分布的方差LED发光。
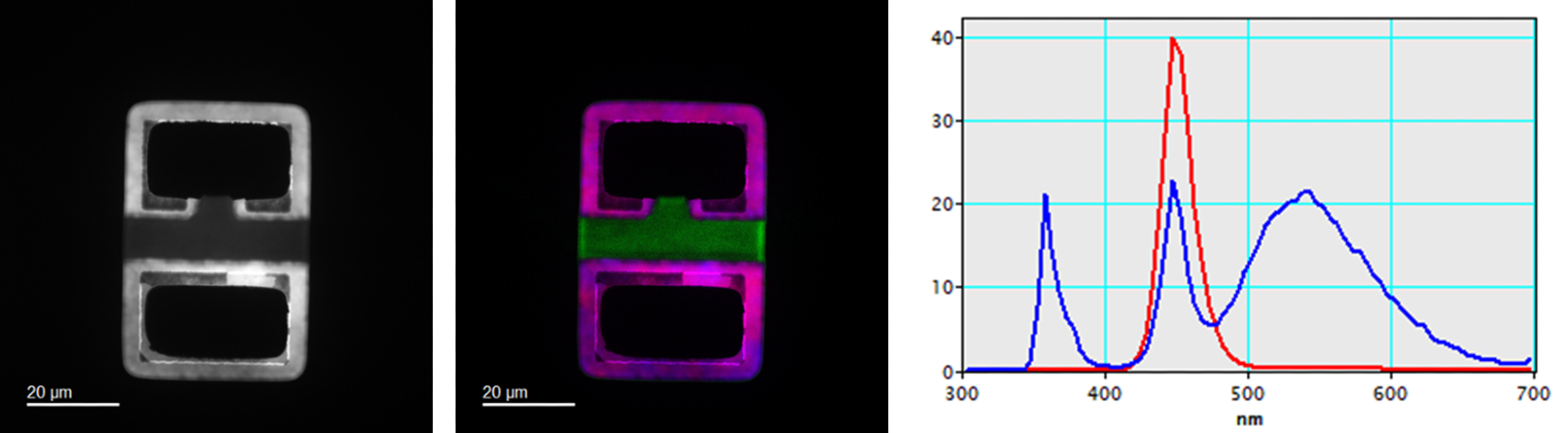
图11。(左)CL光谱图像显示从300年到700纳米波长(中心)的彩色光谱图像突出排放氮化镓(360 nm、绿彩色化),和InxGa1-xN (430 nm,蓝色的彩色化;和460海里,红色的彩色化)20 nm带宽。每种颜色的乐队是由强度归一化。(右)CL光谱从(红色)发光区域和甘(蓝色)中央区域(清晰)增加了10倍。图片来源:Gatan Inc .)
这个中心形象在图11中由三个带通从光谱中提取图像的图像,彩色的堆叠在一起。
排放在430 nm蓝色所代表的强度,而460海里来自红绿和360海里(每20海里带宽)。复合带通图像描绘了红色的地方强度较小,表明低浓度的本地铟0.4%低于16.2%的平均水平(在)。
必须指出这个方差不够大,被拒绝的进一步处理。
图11(右)提出了光谱从光谱中提取图像,从发光(红色),(蓝色,x10)甘地区,表现出很强的强度接近450 nm平行InGaN排放和氮化镓365海里。
摘要和结论
需要大量的时间和资源生产半导体器件。因此,计量和检验是必不可少的,以确保资源配置不是浪费在有缺陷的设备。
CL提供宝贵的检查技术补充EDS,促进多种缺陷类型的直接观察,这导致设备性能显著恶化。
此外,CL图像层表面以下,它允许通过测量设备缺陷影响强度的决心。这种能力支持的发展更健壮的缺陷识别算法基于增强对比度。
EDS可以检测形式的缺陷通过确定的元素成分叛逃的地区。
引用
- d·j·斯托j·d·李和m . Bertilson“辛烷精英和Monarc一起同时捕获EDS和CL,”EDAX洞察力,2020年9月1 - 2日,页。。

这些信息已经采购,审核并改编自Gatan Inc .提供的材料欧洲杯足球竞彩
在这个来源的更多信息,请访问Gatan Inc .)