介绍GydF4y2Ba由于其出色的性质,包括化学惰性,热稳定性和高饱和的电子漂移速度,立方 - 碳化硅(3C-SiC)对高温和高功率应用具有很大的兴趣。其高刚度,高机械强度和极端化学惰性也使其适用于在高温下在化学和物理恶劣环境中使用电压传感器等电子设备的开发,并且在高温下使用[1,2]。对于压力传感器和MEMS的一些应用,需要SIC薄膜沉积在SIO等绝缘体上GydF4y2Ba2GydF4y2Ba,所谓的SIC-绝缘体(SICOI)结构,因为有源层必须朝向基板电隔离。GydF4y2Ba 已经报道了几种制造SiCOI结构的方法,即1)立方SiC(3C-SiC)在Si-on绝缘体(SOI)基板[3,4],2)离子注入和晶片键合[5]和3)绝缘体上的3C-SiC的直接生长[6,7]。在这些方法中,绝缘体上的3C-SiC的直接生长是最理想的方法,因为它是最简单的并且具有良好的成本性能。为了将SiC膜施加到压力传感器上,由于其大规格因子,需要(100)或(110)取向的晶体膜。在外延N-SiC膜的情况下,通过在<110>方向上施加拉伸应力,通过在<100>方向上施加拉伸应力,在<100>方向上施加拉伸应力的大规号因子[8]。这些依赖性起源于导带结构。但是,当SiC在SiO等绝缘体上生长时GydF4y2Ba2GydF4y2Ba或如果GydF4y2Ba3.GydF4y2BaNGydF4y2Ba4.GydF4y2Ba通过低压CVD (LPCVD)和溅射,形成多晶薄膜[6,7]。GydF4y2Ba 到目前为止,我们已经研究了用三极管等离子体CVD[9]在Si衬底上外延生长3C-SiC,该方法利用高密度氢自由基在低温下生长薄膜。采用单甲基硅烷(MMS)为源气体的三极管等离子体CVD,在Si(100)上异质外延生长了超过900的3C-SiCGydF4y2Ba°GydF4y2BaC[9]。结果表明,即使在低温下,高密度氢自由基与MMS前驱体的反应也会大大促进晶体的生长。如果在SiO上直接生长高质量(100)或(110)取向的SiC薄膜GydF4y2Ba2GydF4y2Ba在美国,SiC压力传感器可以用一种简单的方法制作。GydF4y2Ba 在这项研究中,我们研究了SIO上的SIC结晶膜生长GydF4y2Ba2GydF4y2Ba/以MMS和二甲基硅烷(DMS)为源气体,采用三极管等离子体CVD法在硅衬底上制备SiCOI结构,并对SiC薄膜的压阻性能进行了评价。GydF4y2Ba 实验的程序GydF4y2Ba图1显示了SiC生长中使用的三极管等离子体CVD装置的示意图。三极管等离子体CVD系统的丝网电极(栅极,直径= 135mm)放置在GydF4y2Ba常规二极管型射频等离子体CVD室的阴极(直径= 85 mm)和阳极(直径= 100 mm)。阴极周围是一个接地的圆柱形不锈钢壁(直径135毫米)。将网格(线径0.3 mm,线距1.3 mm)与接地墙连接。通过在栅极上施加不同的直流偏差(100 ~ -100 V),我们试图控制带电粒子对衬底表面的冲击。欧洲杯猜球平台利用双探针法发现,在负偏置(-50 ~ -100 V)下,栅极与阳极之间的余辉区域电子温度较低(<1 eV),如图2所示。GydF4y2Ba 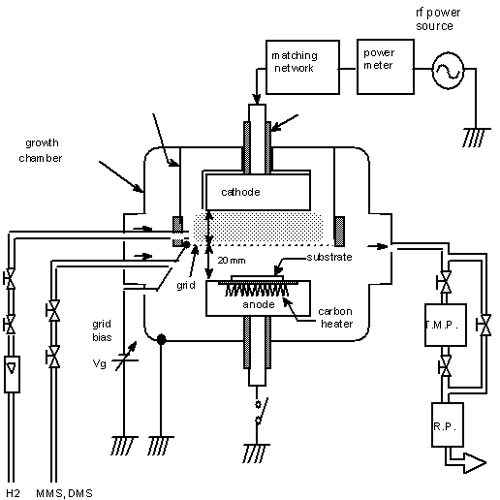
图1GydF4y2Ba。GydF4y2Ba三极管等离子体CVD装置的示意图。GydF4y2Ba 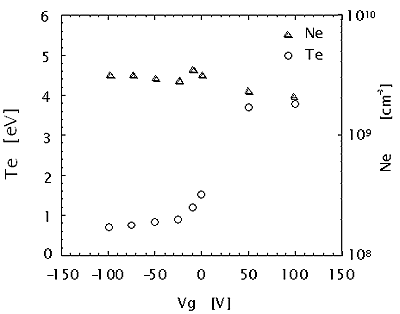
图2GydF4y2Ba。GydF4y2Ba通过双探针测量的余辉区域中的电子温度和电子密度的变化。GydF4y2Ba 基板被放置在电浮阳极上。基础压力低于6.7GydF4y2BaXGydF4y2Ba10.GydF4y2Ba-5GydF4y2BaPA在生长室中,使用涡轮分子泵和机械旋转泵抽空。Si(100)底物,在1000时在干氧气氛中热氧化GydF4y2Ba在电炉中放置6小时。硅溶胶的厚度GydF4y2Ba2GydF4y2Ba图层约为200-300纳米。GydF4y2Ba 实验条件如下:阴极和栅格20mm之间的距离,电网和衬底之间的距离20 mm,hGydF4y2Ba2GydF4y2Ba流速200 SCCM,MMS和DMS气体(TRI CHEM。实验室。INC.,99.9999%)压力在薄膜生长期间的压力1.3GydF4y2BaXGydF4y2Ba10.GydF4y2Ba-2GydF4y2BaPA,燃气进料比H.GydF4y2Ba2GydF4y2Ba/(MMS或DMS)= 85,衬底温度500-700GydF4y2Ba°GydF4y2BaC,探针测量期间的总气体压力和薄膜生长133Pa,RF功率100W。在没有MMS的探针测量期间通过RF(13.56MHz)放电产生氢等离子体。GydF4y2Ba SIC增长的程序如下。在10以下的生长室抽空后GydF4y2Ba-4GydF4y2Ba将衬底温度提高到300℃GydF4y2Ba°CGydF4y2Ba,这是低于分解温度的源气体,由碳加热器。HGydF4y2Ba2GydF4y2Ba和MMS(或DMS)相比,衬底温度从300℃迅速升高GydF4y2Ba°GydF4y2BaC到生长温度,导致薄膜生长。同时,向阴极提供射频功率,并向栅极添加负直流偏置。用x射线衍射仪(RIGAKU, radiia;DS 1/2GydF4y2Ba˚GydF4y2Ba,0.15mm,ss 1/2GydF4y2Ba˚GydF4y2Ba)和红外分光光度计(Hitachi Model 260-10)。GydF4y2Ba 结果和讨论GydF4y2Ba数字GydF4y2Ba图3示出了SIO的红外(IR)传输光谱GydF4y2Ba2GydF4y2Ba/ Si底物在600次SIC生长之前和之后GydF4y2Ba˚GydF4y2Bac 3小时。SiC生长后基材的光谱呈现795cm的急剧吸收峰GydF4y2Ba-1GydF4y2Ba,表示化学计量SiC晶体的横光学(To)声音[10]。在薄膜生长后,Si-O键的吸光度几乎没有变化。尽管提供高密度氢基团的供应,但是在通过三极管等离子体CVD的SiC生长期间难以蚀刻Si衬底上的氧化物层。GydF4y2Ba 
图3.GydF4y2Ba。GydF4y2BaSiO的FTIR光谱GydF4y2Ba2GydF4y2Ba/ Si基质在SiC生长之前和之后。GydF4y2Ba 图4显示了在SiO上生长的SiC膜的X射线衍射光谱GydF4y2Ba2GydF4y2Ba层600GydF4y2Ba°C使用MMS和DMSGydF4y2Ba。如在图中可以看出,在使用MMS生长的SiC膜的光谱中观察到SiC(220)衍射峰,而使用DMS生长的SiC膜的峰值观察到(111)。来自这些光谱,发现SIC膜在SIO上生长GydF4y2Ba2GydF4y2Ba使用MMS的层定向到<110>方向。这(110)导向的SIC膜预计将具有一定的仪表因子。因此,通过使用桥接电路的应变下的电阻改变来评价(110)取向SiC膜的压阻性质。GydF4y2Ba 
图4:GydF4y2BaSiO上生长的SiC膜的X射线衍射光谱GydF4y2Ba2GydF4y2Ba/硅基板GydF4y2Ba使用MMS和DMS作为源气体。GydF4y2Ba 图5显示了GydF4y2Ba评估(110)取向SiC薄膜规格因数的桥式电路原理图。RGydF4y2Ba一种GydF4y2Ba, RGydF4y2BaB.GydF4y2Ba和RGydF4y2BaCGydF4y2Ba是标准的金属膜电阻器。RGydF4y2BaXGydF4y2Ba为碳化硅样品。为了准确地求得电阻的变化,用RGydF4y2Ba一种GydF4y2Ba, RGydF4y2BaB.GydF4y2Ba和RGydF4y2BaCGydF4y2Ba被选中与SiC样本的相同。在拉伸应变下,SiC膜的阻力从r变化GydF4y2BaXGydF4y2Ba到RGydF4y2BaXGydF4y2Ba+GydF4y2BaΔGydF4y2BaR和输出电压变化。根据以下等式可以从输出电压的变化可以获得电阻。GydF4y2Ba  (1)GydF4y2Ba
(1)GydF4y2Ba
在哪里GydF4y2BaV.GydF4y2Ba出GydF4y2Ba(0)是零应变的输出电压,GydF4y2BaV.GydF4y2Ba出GydF4y2Ba(σ)GydF4y2Ba是在菌株GydF4y2BaσGydF4y2Ba。GydF4y2Ba 根据定义,可以得到规范系数。GydF4y2Ba  (2)GydF4y2Ba
(2)GydF4y2Ba
在哪里GydF4y2BaεGydF4y2Ba马克斯GydF4y2Ba为施加在样品上的应变。如果GydF4y2BaΔGydF4y2BaR为正,规范因子为正。GydF4y2Ba 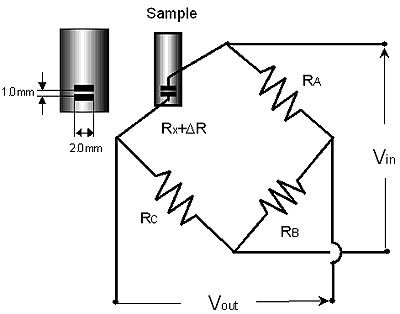
图5。GydF4y2Ba评估应变下(110)取向SiC薄膜应变系数的桥式电路原理图。GydF4y2Ba 图6显示了(a)桥电路输出电压和(b) SiC薄膜在力作用下电阻的变化。压力GydF4y2BaεGydF4y2Ba马克斯GydF4y2Ba从考虑样本尺寸和测量条件的力转换。在2.9 N的拉伸力下,电阻下降了0.068%。从样品电阻的变化,测量因子评估为-2.2。虽然与SiC外延膜的膜[8]相比,该值略微较小,但是通过优化生长条件,将实现压阻性质的改善。GydF4y2Ba 
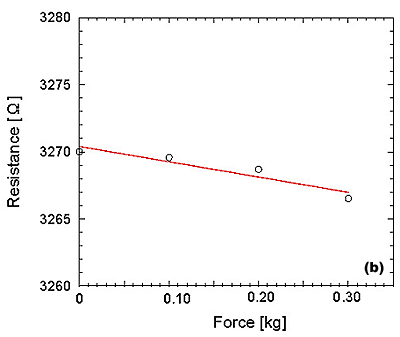
图6.GydF4y2Ba。GydF4y2Ba(a)桥电路的输出电压的变化和(b)拉伸应变下的(110)定向SiC膜的电阻。GydF4y2Ba 结论GydF4y2Ba为了制备适用于压力传感器的SiCOI结构,在SiO 2上生长3C-SiC晶体薄膜GydF4y2Ba2GydF4y2Ba/研究了利用氢自由基和MMS的三极管等离子体CVD硅衬底。在负栅偏压条件下,在600℃低温下生长了(110)取向的晶体薄膜GydF4y2Ba°CGydF4y2Ba. 从硅衬底上生长的SiC(110)取向薄膜电阻的变化GydF4y2Ba2GydF4y2Ba层,规范因子估计约为-2.2。GydF4y2Ba 工具书类GydF4y2Ba1。GydF4y2BaM.Mehregany,C.A.Zorman,N.Rajan和C.H.Wu,“恶劣环境下的碳化硅MEMS”项目。IEEE,GydF4y2Ba卷。GydF4y2Ba86.GydF4y2Ba那GydF4y2Ba1594-1610GydF4y2Ba那GydF4y2Ba(1998)。GydF4y2Ba 2。GydF4y2BaP. M. Sarro,《硅》(Silicon)GydF4y2BaCGydF4y2Ba阿尔贝德GydF4y2BaNGydF4y2Baew mems.GydF4y2BaT.GydF4y2Ba“技术”,传感器执行器,GydF4y2Ba卷。GydF4y2Ba82.GydF4y2Ba那GydF4y2Ba210-218GydF4y2Ba那GydF4y2Ba2000GydF4y2Ba 3.GydF4y2BaW. Reichert,E. Obermeier和J. Stoemenos,“GydF4y2BaβGydF4y2Ba原文如此GydF4y2BaFGydF4y2BaSOI上的ilmsGydF4y2BaS.GydF4y2BaUbStrateGydF4y2BaHGydF4y2BaIgh-Metige.GydF4y2Ba一种GydF4y2Ba应用”,钻石相关。主语。,GydF4y2Ba卷。GydF4y2Ba6.GydF4y2Ba那GydF4y2Ba1448 - 1450GydF4y2Ba那GydF4y2Ba1997.GydF4y2Ba 4。GydF4y2BaS. Hirai,F. Jobe,M. Nakao和K.Izumi,“使用传统电炉将SOI晶圆变化为3C-SIC的研究”Mater。科学。论坛,GydF4y2Ba卷。GydF4y2Ba389-393GydF4y2Ba那GydF4y2Ba347-350.GydF4y2Ba那GydF4y2Ba2002GydF4y2Ba 5。GydF4y2BaC. Serre, A. R. Rodriguez, A. P. Rodoriguez, J. R. Morante, L. Fonseca, M. C. Acero, R. Kogler和W. Skorupa, "GydF4y2BaβGydF4y2Ba-SiC/SiOGydF4y2Ba2GydF4y2BaFGydF4y2Ba默示GydF4y2Ba一世GydF4y2Ba在…上GydF4y2Ba一世GydF4y2Bamplantation和GydF4y2BaB.GydF4y2Baonding for.GydF4y2BamGydF4y2BaICMOROMENICSGydF4y2Ba一种GydF4y2Ba保藏“,Sens。执行器,GydF4y2Ba卷。GydF4y2Ba74.GydF4y2Ba那GydF4y2Ba169 - 173GydF4y2Ba那GydF4y2Ba1999.GydF4y2Ba 6。GydF4y2BaC. H. Wu, C. A. Zorman, M. Mehregany, "表征GydF4y2BaP.GydF4y2Ba在SiO上种植的Olycrystalline SicGydF4y2Ba2GydF4y2Ba和si.GydF4y2Ba3.GydF4y2BaNGydF4y2Ba4.GydF4y2Baby APCVD for MEMS Applications”,Mater。科学。论坛,GydF4y2Ba卷。GydF4y2Ba338-342.GydF4y2Ba那GydF4y2Ba541-544GydF4y2Ba那GydF4y2Ba2000GydF4y2Ba 7。GydF4y2BaY. Onuma,R. Okada,H. Ono和K.Amimura,SICGydF4y2BaGGydF4y2BaSiO的罗斯GydF4y2Ba2GydF4y2BaL.GydF4y2Ba艾耶尔的射频GydF4y2BaS.GydF4y2Ba“晃,Proc, Int。《碳化硅及其相关材料》,《中国机械工程》19欧洲杯足球竞彩93年第1期。GydF4y2Ba 8。GydF4y2BaJ. S. Shor,D.Goldstein和A. D.Kurtz,“N型表征GydF4y2BaB.GydF4y2Ba-GydF4y2BaSIC作为A.GydF4y2BaP.GydF4y2Baieeee trans“ieozionesistor。电子设备,GydF4y2Ba卷。GydF4y2Ba40.GydF4y2Ba那GydF4y2Ba1093 - 1099GydF4y2Ba那GydF4y2Ba1993GydF4y2Ba 9。GydF4y2BaK. Yasui, K. Asada, T. Maeda and T. Akahane, "成长的GydF4y2BaHGydF4y2Baigh-qualityGydF4y2BaS.GydF4y2BailiconGydF4y2BaCGydF4y2Ba在Si上打押电影GydF4y2BaT.GydF4y2Ba里奥德GydF4y2BaP.GydF4y2Ba莱马CVD使用GydF4y2BamGydF4y2Baonomethylsilane“,苹果酱。冲浪。SCI。,GydF4y2Ba卷。GydF4y2Ba175-176GydF4y2Ba那GydF4y2Ba495-498GydF4y2Ba那GydF4y2Ba2001.GydF4y2Ba 10GydF4y2BaY.Hshita,“通过CHI的化学气相沉积低温P掺杂SiC生长GydF4y2Ba3.GydF4y2BaSIH.GydF4y2Ba3.GydF4y2Ba/ ph.GydF4y2Ba3.GydF4y2Ba气体“,J. Electrochem。SOC。,GydF4y2Bavo。GydF4y2Ba142.GydF4y2Ba那GydF4y2Ba1002-1006GydF4y2Ba那GydF4y2Ba1995.GydF4y2Ba 联系方式GydF4y2Ba |