在格勒诺布尔举行的IEEE IITC会议上,纳米电子学研究中心imec和Lam研究公司今天展示了一种新型的自底向上预填充技术。
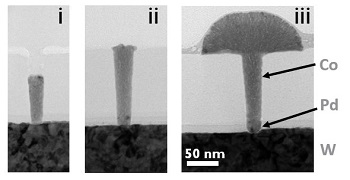
该技术基于钴(Co)的化学沉积(ELD),是一种高选择性的方法,可实现通孔和接触孔的无空洞填充。潜在地提高了电路性能,这是扩展高级互连和实现未来7纳米及以下逻辑和DRAM节点的有前途的途径。
随着逻辑和内存节点的扩展,这些高级互连的性能会受到互连电阻增加的负面影响。此外,在规模较大的孔道中出现的孔洞严重影响产量。
Imec的先进互连工业联盟计划正在探索新的金属化方法来解决这些问题。解决这一问题的一种方法是确定集成和金属化的替代方案,在不影响可靠性和产量的情况下,提供比传统技术更好的电阻。
与Lam Research一起,Co ELD技术被证明是一种可行的方法,用于高度选择性的自下而上接触填充,并通过预填充钴(Co)作为铜(Cu)的替代金属。此外,与化学气相沉积(CVD)相比,ELD工艺的高选择性成本更低,本质上确保了良好的金属-金属界面,并通过填充和提高收率铺平了无空隙的道路。
沟槽填充率和线电阻也可能受益于线的解耦和通过长宽比,允许每个设计最佳电阻/电容(RC)。因此,Co预填充ELD有潜力实现未来高级逻辑和存储技术的扩展。
这一成果是与imec核心CMOS方案的主要合作伙伴合作取得的:GlobalFoundries、Intel、Samsung、SK hynix、Sony、TSMC、Amkor、Micron、Utac、Qualcomm、Altera、富士通、松下和Xilinx。